什么事盲埋孔线路板
 什么是盲埋孔?
什么是盲埋孔?
随着目前便携式产品的设计朝着小型化和高密度的方向发展,
PCB的设计难度也越来越大,对
PCB的生产工艺提出了更高的要求。在目前大部分的便携式产品中使0.65mm间距以下BGA封装,均使用了盲埋孔的设计工艺,那么什么是盲埋孔呢?
盲孔(Blind vias / Laser Vias) :盲孔是将PCB内层走线与PCB表层走线相连的过孔类型,此孔不穿透整个板子。
埋孔(Buried vias):埋孔则只连接内层之间的走线的过孔类型,所以是从PCB表面是看不出来的。
一个8层板的剖面结构示意图:
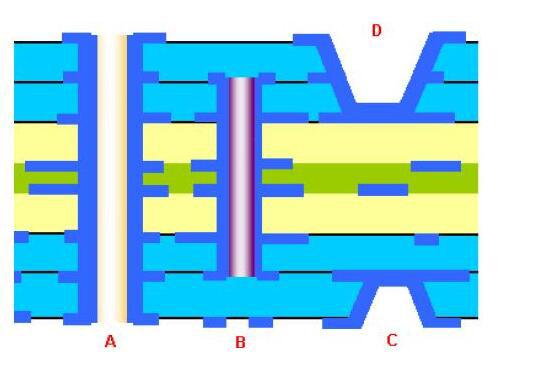
A:通孔(L1-L8)
B:埋孔(L2-L7)
C:盲孔(L7-L8)
D:盲孔(L1-L3)
注:下面的例子均以8层板为例
盲埋孔的设置
设置Via类型
• 点击菜单的Setup-Pad Stacks,再选择Pad Stack Type中的Via选项,出现如右图设置对话框。
• 点击左下部的Add Via按钮,进行您所需要的Via类型的设置,包括其钻孔尺寸,各层外径尺寸等等参数。
• 如右图进行了3种类型的盲埋孔设置和一种通孔类型的设置。
•如果是通孔类型,在左下部的Vias选项中选择Through,如果是盲埋孔类型,选择Partial选项
•当选择Partial类型的过孔时,必须指定其起始层(Start Layer)和结束层(End Layer)。如
V12和V27类型的盲埋孔设置如下图

盲埋孔制作知识:
随着电子产品向高密度,高精度发展,相应对线路板提出了同样的要求。而提高pcb密度最有效的方法是减少通孔的数量,及精确设置盲孔,埋孔来实现。
1. 盲孔定义a:与通孔相对而言,通孔是指各层均钻通的孔,盲孔则是非钻通孔。(图示说明,八层板举例:通孔,盲孔,埋孔) b:盲孔细分:盲孔(BLIND HOLE),埋孔 BURIED HOLE(外层不可看见); c:从制作流程上区分: 盲孔在压合前钻孔,而通孔是在压合后钻孔。
2. 制作方法:a:钻带:
(1):选取参考点: 选择通孔(即首钻带中的一个孔)作为单元参考孔。
(2):每一条盲孔钻带均需选择一个孔, 标注其相对单元参考孔的坐标。
(3):注意说明哪条钻带对应哪几层:单元分孔图及钻咀表均需注明,且前后名称需一致;不能出现分孔图用a b c表示,而前面又用1st,2nd表示的情况。
注意当激光孔与内层埋孔套在一起,即两条钻带的孔在同一位置上,需问客移动激光孔的位置以保证电气上的连接。
B:生产pnl板边工艺孔:
普通多层板: 内层不钻孔;
(1):铆钉gh,aoi gh,et gh均为蚀板后打出(啤出)
(2):target 孔(钻孔gh) ccd:外层需掏铜皮,x-ray机:直接打出,且注意长边最小为11inch。(11228)
盲孔板:
所有tooling孔均为钻出,注意铆钉gh;需啤出,避免对位偏差。
(aoi gh也为啤出),生产pnl板边需钻字,用以区分每块板。
3. Film修改:
(1):注明film出正片,负片:
一般原则:板厚大于8mil(不连铜) 走正片流程;
板厚小于8mil(不连铜)走负片流程(薄板);
线粗 线隙谷大时需考虑d/f时的铜厚,而非底铜厚。
盲孔ring做5mil即可,不需做7mil。
盲孔对应的内层独立pad需保留。
盲孔不能做无ring孔。
4. 流程:
埋孔板与普通双面板做法一致。
盲孔板,即有一面是外层:
正片流程:需做单面d/f,注意不能辘错面(双面底铜不一致时);d/f曝光时,光铜面用黑胶带盖住,防止透光。
因盲孔板做两次以上板电,图电,成品极易板厚超厚,因此图电注意控制板厚铜厚,蚀刻后注明铜厚 板厚的范围。
压完板后用x-ray机打出多层板用target孔。
负片流程:针对薄板(〈12mil连铜〉因其无法在图电拉生产,必须在水金拉生产,而水金拉无法分面打电流,故无法按mi要求做单面不打电流或打小电流。如走正片流程,常导致单面铜厚超厚,造成蚀刻困难,幼线的现象,因此此类板需走负片流程。
5. 通孔,盲孔的钻孔顺序不同,制作时偏差不一致;
盲孔板较易产生变形,开横直料对多层板对位和管位距控制有难度,故开料时只开横料或只开直料。
6. Laser drill:
LASER DRILL为盲孔的一种,有自身的特点:
孔径大小:4—6 mil
pp thickness须〈=4。5mil,根据纵横比〈=0.75:1计算得出
选用pp有三种:LDPP 106 1080; FR4 106 1080 ;RCC 。
7. 如何界定埋孔板需要用树脂塞孔:
a. H1(CCL):H2(PP) 〉=4 厚度比
b. HI(CCL) 》32 MIL
c. 2OZ 及2OZ以上激光埋孔板;高厚铜,高tg板需采用树脂封孔。
此类板的行板流程需注意先用树脂封孔再做线路以免对线路造成较大的损伤。

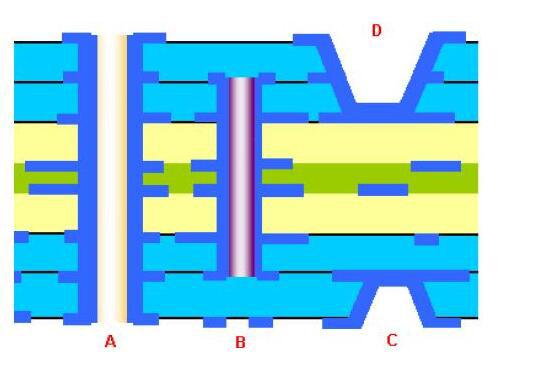


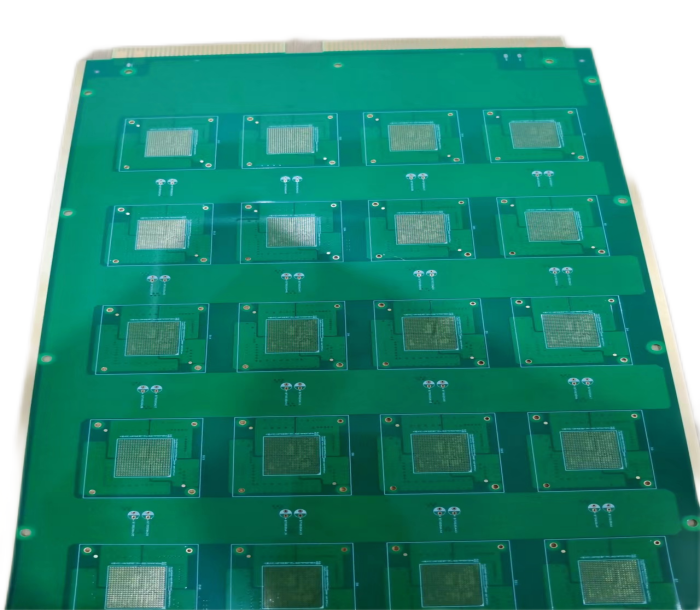


 咨询热线:
咨询热线:
